日本特殊陶業がICパッケージ内微細配線で新技術、「FlatPlug SR」を提案:CEATEC 2014
日本特殊陶業は、「CEATEC JAPAN 2014」において、30μm以下にもなるパッケージ基板の微細配線に最適な新技術「FlatPlug SR」を提案した。
日本特殊陶業は、「CEATEC JAPAN 2014」(シーテック ジャパン/2014年10月7〜11日、幕張メッセ)において、MPUやフリップチップを用いるCSPなどに用いられる、30μm以下にもなるパッケージ基板の微細配線に最適な新技術「FlatPlug SR」を提案した。
同社のICパッケージ材料と言えばセラミックが知られているが、樹脂も手掛けている。FlatPlug SRは、資本提携するイースタンがメモリ用基板のプリプレグに展開している技術を、日本特殊陶業が培ってきた樹脂材料の技術を活用してパッケージ基板向けに製品化したものだ。
現在、端子数の多いプロセッサ系ICのパッケージは、外縁部側にバンプを配置するペリフェラルBGAを使用することが多い。シリコンダイ裏面の銅ポストと端子をつなぐのは、パッケージ基板上にめっきプロセスで形成した30μm以下にもなる線幅の微細配線である。半導体プロセスの微細化が進むと、この微細配線もさらに細くなり、現在は線幅が20〜15μmに達する事例もあるという。
ここまで微細配線が細くなると、配線間が短絡したり、アンダーフィルを入れた際にボイドが発生したりといった、動作不具合につながる問題が発生しやすくなる。
FlatPlug SRは、形成した微細配線の間を樹脂材料で埋めることによって、配線間の短絡などが起こらないようにする技術だ。日本特殊陶業は、「FlatPlug SRを適用したパッケージ基板を使えば、微細化が進む半導体の、パッケージに起因する歩留まりの低下に対応できる」としている。ただし、使用している材料やプロセスについては「公開していない」(同社)ということだった。
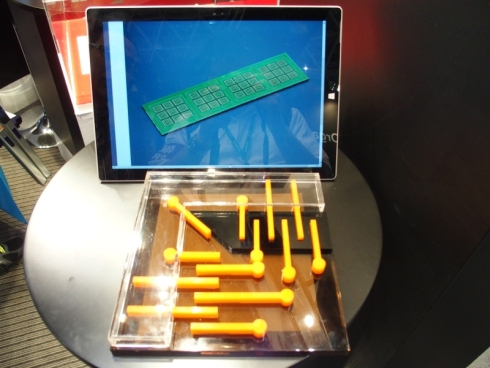 「FlatPlug SR」を適用したパッケージ基板(上)と構造のイメージ。下側の構造のイメージのうち、微細配線(黄色)の周辺を埋める濃い緑色の部分がFlatPlug SRで用いる樹脂材料となっている(クリックで拡大)
「FlatPlug SR」を適用したパッケージ基板(上)と構造のイメージ。下側の構造のイメージのうち、微細配線(黄色)の周辺を埋める濃い緑色の部分がFlatPlug SRで用いる樹脂材料となっている(クリックで拡大)関連記事
 第20回 部品の内層実装
第20回 部品の内層実装
実装分野の最新技術を分かりやすく紹介する前田真一氏の連載「最新実装技術あれこれ塾」。第20回は、日本が伝統的に世界で優位に立っている実装技術「部品内装基板」について解説する。 第15回 新しいMCM(2.5D実装)
第15回 新しいMCM(2.5D実装)
実装分野の最新技術を分かりやすく紹介する前田真一氏の連載「最新実装技術あれこれ塾」。第15回は、先端FPGAなどへの採用が始まっている、新たなMCM技術である2.5次元(2.5D)実装について説明する。
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- 品質保証とは何か、その定義を改めて考える
- タイの半導体製造工場で新棟が完成、ソニーセミコンが生産力を強化
- 三菱重工が航空機エンジン部品工場を増強、内製力強化で完全一貫生産を実現
- パワー半導体の電流測定が正確に、光プローブを用いた電流波形測定用センサー
- ルネサスが甲府工場で300mmウエハーライン稼働、パワー半導体の生産能力を2倍に
- 日立産機が三菱電機 名古屋製作所の配電用変圧器事業を譲受、2026年4月に統合完了
- 工場でCO2排出量1次情報をなぜ取得すべきなのか 85%以上の削減効果も
- 誤差9割、コストを抑えるためにもCO2排出量は測った方がよい
- OTセキュリティを巡るエネルギー業界の法改正とは、変わる事業者の事故対応
- IEC 62443とは何か、工場のサイバーセキュリティ対策のカギを握る国際標準を解説



