第15回 新しいMCM(2.5D実装):前田真一の最新実装技術あれこれ塾(1/3 ページ)
実装分野の最新技術を分かりやすく紹介する前田真一氏の連載「最新実装技術あれこれ塾」。第15回は、先端FPGAなどへの採用が始まっている、新たなMCM技術である2.5次元(2.5D)実装について説明する。
本連載は「エレクトロニクス実装技術」2012年6月号の記事を転載しています。
1. SoCとMCM(SiP)
MCM(Multi Chip Module)は大型コンピュータ用に開発され、その後高集積部品としていろいろな方面で使われている技術です。
現在では、複数の部品を一つの部品に封止してSiP(System in Package)とかMCP(Multi-Chip Package)と呼ばれる事も多くなっています(図1)。メモリやコントローラ、CPUなどいろいろな回路ブロックを組み合わせて1チップのLSIに集積するSoC(System on Chip)(図2)がシステムICとして多くなリましたが、最近、このSoCからMCMへ変化する動きが出てきました。
本稿では、最近のMCMへの動きを紹介します。
2. MCM
MCMは範囲が広く、使われている技術や目的によって大きく異なっています。そこで、MCMは用途や材料などいくつかに分類されます。
ここでは、MCMに使われる基板材料と技術によって分類します。
まず、MCM-C(Ceramic)と呼ばれる分類があります。これは多層セラミック基板で配線を行い、その基板の上にICチップやチップ部品、印刷部品を配置したものです(図3)。セラミックはICの発熱に対する特性も良く、超多層化が可能なため、大型コンピュータなど向けとして、最初に開発されたMCM技術です(図4)。技術的には、配線パターンや抵抗などの作成に厚膜の印刷技術を使う場合があります。
現在も、衛星や通信などの分野で多く使われています。また、パッケージに封止して、SiPとして使うだけではなく、大きなモジュールとしても良く使われています(図5)。
基板材料に積層(Laminate)基板を使用するMCMをMCM-Lと呼び、民生機器を中心に多く使われています。基板材料としては多層高密度配線にはポリイミドなどが使われますが、ビルドアップ技術を使い、一般のFR-4なども使われます。PoP実装して、封止した部品なども広い意味ではこの分類に入るかもしれません。銅箔のエッチングやビルドアップ技術を使って配線を成形します(図6)。
このほかにMCM-D(Deposited=蒸着)と呼ばれるMCM技術があります。
これは基板材料としてシリコン基板やガラス基板を使用し、薄膜技術により配線パターンを成形しようというものです(図7)。
MCM-Dは非常にファインな配線が成形でき、基板の材料もICチップと似たものを使用するため、熱や電気的な特性もチップと基板の間で大きな違いがなく、高速、高集積度のMCMが作成できます。
これまでのMCM-D技術では、配線の多層化など価格面での問題があり、限られた分野にしかMCM-Dは使われませんでした。
しかし、ここにきてICチップの3D実装がDDRメモリに要求され、TSV技術が必須要素技術として急速に進歩、一般化してきました。このTSV技術を使ったMCM-Dが急速に注目されるようになってきました。
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- ラズパイの電源を入れてみた
- PLCレスで協働ロボットの外部軸を制御、自動化システム構築の工数削減
- ハノーバーメッセが開幕、AIや水素など「競争力ある持続可能な産業」の最新技術
- 品質保証とは何か、その定義を改めて考える
- HOYA、生産ラインや受注システムのシステム障害からほぼ復旧
- マレーシアで半導体ウエハーバンピングの受託加工向け製造装置増設
- IEC 62443とは何か、工場のサイバーセキュリティ対策のカギを握る国際標準を解説
- RYODENらが生成AIの事業応用で協業、現場映像と設備データの融合も目指す
- 高出力仕様の溶接電源でより幅広い施工に対応、パナの次世代コントローラー
- タイの半導体製造工場で新棟が完成、ソニーセミコンが生産力を強化
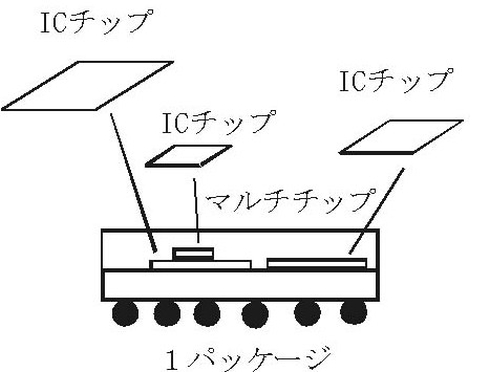 図1 SiP(System in Package)
図1 SiP(System in Package)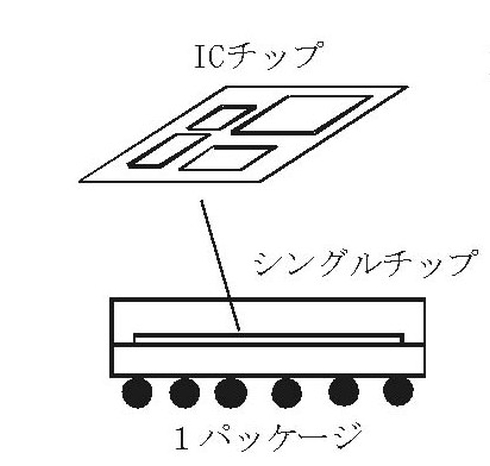 図2 SoC(System on Chip)
図2 SoC(System on Chip) 図3 MCM-C セラミック基板に印刷抵抗 出典:Omega Technology Inc.
図3 MCM-C セラミック基板に印刷抵抗 出典:Omega Technology Inc.

 図6 MCM-L
図6 MCM-L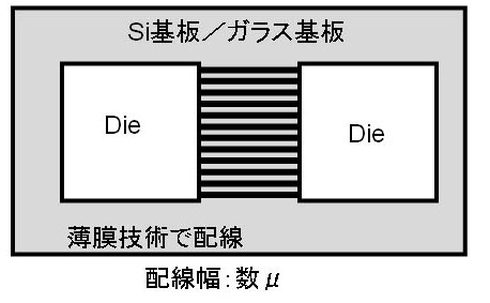 図7 MCM-D
図7 MCM-D

