第50回 モジュールとエンベデッドパッシブ:前田真一の最新実装技術あれこれ塾(4/5 ページ)
4.オン・パッケージ・パスコン
LSIのピン数が膨大になり、ICチップの端子(ダイ・パッド)からBGAのボール(部品端子)までの配線が複雑になっています。このため、パッケージ内基板も多層化して、配線にビアを使ったり、微細化しています。配線は細いほどL成分が大きくなります。
このため、BGAの部品端子からダイ・パッドまでの配線は短くても大きなL成分を持っています。
基板上のバイパスコンデンサが電源変動を抑えようとしても、バイパスコンデンサからICの電源/グランド・ダイまでの間にインタポーザ配線のLが存在するために高速な電源ノイズは消去できません。
そこで、高速で大きなスイッチングノイズが発生するようなLSIでは、パッケージ内のインタポーザ基板の上にバイパスコンデンサを搭載するようになりました(図15)。
基板と違ってパッケージは小さいので、パスコンが配置できる領域も限られていて多くのコンデンサを実装することは困難です。
コンデンサを基板内部に実装するエンベデッドパッシブも使われます。
5.エンベデッドパッシブ
部品を基板の内装に実装するエンベデッドパッシブは日本独自の実装技術として期待されています。一部では普及してきました。
短所としては、コストが挙げられます。単に製造コストが高いだけではなく、実装した後、検査で不良が発見された場合、リペアが困難なため、歩留まりが悪くなります。さらに、テストや良否判定が困難になります。
また設計も困難になり、特に部品の存在する場所にはスルーホールビアや配線が配置できません。
長所としては、実装面積の縮小が実現できます。
また、特にバイパスコンデンサの場合には、IC部品のグランドピン、電源ピンの直下にコンデンサが配置でき、最短配線で配線できるため、配線のL成分を小さくできます(図16)。
内層実装されたコンデンサを接続する場合、スルーホールビアを使うと部品層から先のビアは余計なスタブ配線となり、大きなL成分となります。このため、パスコンを内層実装する場合、基板はビルドアップとし、IVHを使わないと、内層実装のメリットは得られません(図17)。
このようなエンベデッドパッシブの長所、短所から、エンベデッドパッシブは一般の基板には向いておらず、パッケージ内基板がマーケットということが分かります。
基板にエンベデッドパッシブでバイパスコンデンサを実装しても、バイパスコンデンサの性能は向上しません。基板上のバイパスコンデンサは、コンデンサからICチップのゲランド/電源パッドまでの途中にあるパッケージ内基板のLの影響を受けます。このパッケージ内基板のLの方が大きいため、基板上にあるコンデンサのL成分を小さくしても、意味はありません(図17)。
また、基板コストは面積に比例するため、大きなマザーボードでは高価なエンベデッドパッシブ実装を使ったビルドアップ基板は大きなコストアップにつながります。
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- 品質保証とは何か、その定義を改めて考える
- タイの半導体製造工場で新棟が完成、ソニーセミコンが生産力を強化
- 三菱重工が航空機エンジン部品工場を増強、内製力強化で完全一貫生産を実現
- パワー半導体の電流測定が正確に、光プローブを用いた電流波形測定用センサー
- ルネサスが甲府工場で300mmウエハーライン稼働、パワー半導体の生産能力を2倍に
- 日立産機が三菱電機 名古屋製作所の配電用変圧器事業を譲受、2026年4月に統合完了
- 工場でCO2排出量1次情報をなぜ取得すべきなのか 85%以上の削減効果も
- 誤差9割、コストを抑えるためにもCO2排出量は測った方がよい
- OTセキュリティを巡るエネルギー業界の法改正とは、変わる事業者の事故対応
- IEC 62443とは何か、工場のサイバーセキュリティ対策のカギを握る国際標準を解説
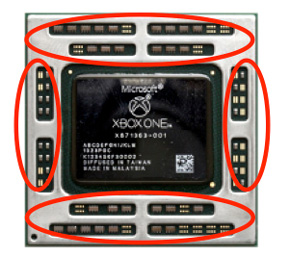 図15:オン・パッケージ・コンデンサ(Xbox Oneの例)
図15:オン・パッケージ・コンデンサ(Xbox Oneの例)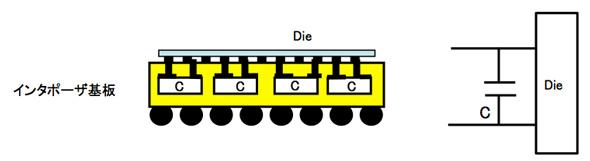 図16:コンデンサの内層実装は特性が良い
図16:コンデンサの内層実装は特性が良い 図17:マザー基板にCを内層実装しても効果はない
図17:マザー基板にCを内層実装しても効果はない

